飞行时间二次离子质谱仪(TOF-SIMS)是飞行时间二次离子质谱仪(TOF-SIMS)作为最前沿实用的表面分析技术之一,可以通过离子束对样品表面进行轰击产生的二次离子可以精确确定表面元素的构成;通过对分子离子峰和官能团碎片的分析可以方便的确定表面化合物和有机样品的结构;配合样品表面扫描和剥离,可以得到样品表面甚至三维的成分图,是表征元素和化合物空间结构的有力工具,是高灵敏,高分辨质谱成像分析的重要技术平台。
TOF-SIMS 5 iontof
PHI NanoTOFII
 预约次数:
119次
预约次数:
119次

一对一解答,测试快人一步
深度剖析-曲线图:

深度剖析3D图:


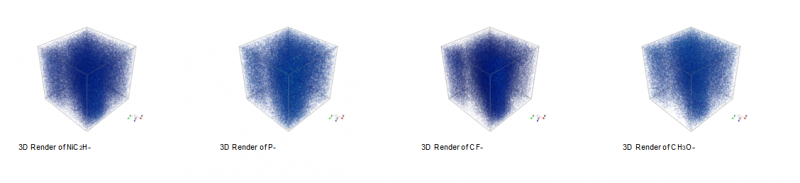
面扫Mapping:

1、深度剖析只能是块体样品,长宽1cm,厚度不超过5mm;
2、粉末只能做质谱或者面扫,液体等粘性样品无法测试。
TOF-SIMS是采用初级离子源(Bi源)入射样品的表面激发出材料里的离子,通常给样品加不同偏压分别采集正离子或负离子,金属离子主要在正离子模式产额比较高,而电负性元素如O\OH\F\Cl\S\N\Br等在负离子模式产额高,如果组分有金属氧化物,比如NiO, 那一定会在正离子模式产生Ni原子离子,以及NixOy的分子离子,而负离子模式一定有O原子离子,同时也有NixOy的分子离子,当然在正离子模式下大多数情况 x>y, 负离子模式下x
正常TOF-SIMS是看不了含量的,数据横坐标是M/Z,纵坐标是强度/计数。理由如下:强度与含量是没有直接关系的。首先,同种基材不同离子的产额不同,产额高的谱峰强度高,但并不代表含量高,也就是说谱峰强弱与含量没有直接对应关系,如果要定量必须选用与测试样品基体效应相同的标准样品,得到灵敏度因子才可以定量!第二,同种离子在不同基体材料中的离子产额也不同,所以同一样品不同离子谱峰强度与含量无关,同种离子在不同材料中的谱峰强弱也与含量无关,只有同种材料的不同样品中的同种离子可以比较,谱峰强度高代表含量高。做深度溅射曲线可以看随深度方向,分子片段的相对变化趋势。
深度剖析正负离子是不同位置;质谱和mapping默认测试是同样一个位置,
